 |
Главная Случайная страница Контакты | Мы поможем в написании вашей работы! | |
Методы изготовления наноразмерных структур (нанотехнология)
|
|
3.1. Эпитаксиальные методы
Эпитаксия – ключевое понятие в технологии ИМС. Специалисты часто используют в своей работе такие выражения, как эпитаксиальный слой, гетероэпитаксиальная структура, жидкофазная или газофазная эпитаксия и т.д. В этой связи, целесообразно напомнить – что называется эпитаксией?
Эпитаксия – это ориентированное наращивание кристаллических слоев на монокристаллическую подложку. Выращенный эпитаксиальный слой повторяет структуру и ориентацию подложки. Если на подложке наращивается эпитаксиальный слой того же состава, что и подложка, то такой вид эпитаксии называется гомоэпитаксией; если иного состава, то гетероэпитаксией. При изготовлении ИМС на кремнии используют гомоэпитаксию (кремний на кремнии). Для получения оптоэлектронных структур (светодиодов, лазеров и т.д.) в видимой области излучения используется гетероэпитаксия. Например, на подложке GaAs наращивают эпитаксиальный слой твердого раствора AlxGa1-xAs (x  ).
).
При любом способе эпитаксии ростовая ячейка должна состоять из источника, содержащего ингредиенты растущего кристалла, среды, с помощью которой осуществляется транспорт атомов в зону роста, и подложки, на которой происходит кристаллизация. Если средой переноса является вакуум, то это вакуумная эпитаксия. В вакууме атомы могут переноситься на подложку в виде молекулярных пучков. Поэтому такой вид эпитаксии называется молекулярно-лучевой (МЛЭ) или молекулярно-пучковой (МПЭ). Если средой переноса служит газ или пар, то эпитаксия называется газофазной или парофазной (ГФЭ). Наконец, если атомы ростового вещества поступают на подложку из жидкой фазы, то это – жидко-фазная эпитаксия (ЖФЭ).
В связи с потребностью создания тонких слоев и многослойных структур с точно заданными геометрическими размерами, электрическими и оптическими свойствами, а также необходимостью создания структур с гетеропереходами, в которых граница между областями была бы свободна от примесей, дефектов и напряжений, связанных с различием параметров двух кристаллических решеток, были разработаны многочисленные технологические приемы.
В предыдущей главе мы рассмотрели ряд наноструктур – квантовые ямы, квантовые точки, сверхрешетки и другие многослойные структуры, перспективные для наноэлектроники. Для нормальной работы приборов на основе этих структур необходимы резкие атомарно гладкие границы между слоями, а толщина слоев во многих случаях должна выдерживаться с атомарной точностью. Очевидно, что слоевые наноструктуры могут быть получены только эпитаксиальным наращиванием. Однако, не все эпитаксиальные технологии могут дать границы наноструктур с нужными свойствами. Например, эпитаксия из газовой фазы по традиционной технологии проводится при высокой температуре (850 – 1000)0 С, что приводит к заметной диффузии атомов в твердой фазе и к размытию границ слоев. Жидкофазная эпитаксия по традиционной схеме не позволяет сформировать сверхтонкие ( ~100 нм) слои достаточно однородные по толщине.
~100 нм) слои достаточно однородные по толщине.
В настоящее время широко используются в основном две технологии: газофазная эпитаксия из металлоорганических соединений (ГФЭМОС) и молекулярно-лучевая эпитаксия (МЛЭ). Ниже мы кратко рассмотрим аппаратурно-методическое оформление этих процессов, их преимущества и недостатки, а также перспективы применения в современной электронике.
3.1.1. Газофазная эпитаксия. Газофазная эпитаксия из
металлоорганических соединений
В начале рассмотрим аппаратурно-методическое оформление газофазной эпитаксии, а затем подробно остановимся на газофазной эпитаксии из металлоорганических соединений.
Газофазная эпитаксия – это ориентированное выращивание кристаллической пленки на подложке из компонент, доставляемых к подложке в виде органических или неорганических соединений в газовой фазе. Кристаллизация газовой смеси осуществляется на нагретой подложке в специальном реакторе (см.рис.3.1.).
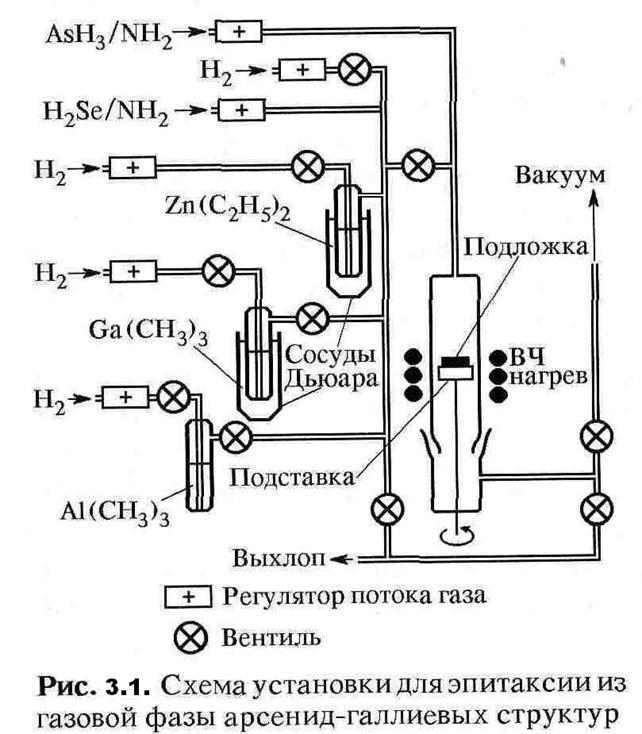
Парциальными давлениями различных газовых компонент можно управлять, контролируя скорость потока от каждого из компонентов, тем самым можно контролировать состав растущей пленки.
Метод газофазной эпитаксии лег в основу промышленной технологии получения кремниевых эпитаксиальных структур. Существует две разновидности этого метода: восстановление тетрахлорида кремния и пиролитическое разложение моносилана. В случае хлоридного метода рост пленки проводится на поверхности подложки кремния, нагретой до 12000 С.
Процесс протекает в кварцевом реакторе, в протоке газовой смеси при атмосферном давлении. Температурный режим обеспечивается индукционным или резистивным нагревателем. Скорость роста составляет 0,2 – 0,3 мкм/мин. Недостатком этого метода является высокая температура, что приводит к автолегированию (проникновение легирующей примеси из подложки в эпитаксиальный слой). Высокая химическая активность хлористого водорода часто приводит к поломкам технологического оборудования. Хлоридный метод не позволял наращивать кремниевые слои на сапфировых подложках, т.к. HCℓ травит сапфир. В силановом методе процесс проводится при более низких температурах (~10500 С), что значительно уменьшает автолегирование и диффузию. В случае ГФЭ легирование эпитаксиальных слоев проводят одновременно с их ростом путем добавления легирующей примеси в газовый поток.
Для выращивания эпитаксиальных слоев соединений А3В5 и, прежде всего, GaAs из газовой фазы существуют три наиболее широко распространненых метода. Первый связан с использованием галогенных соединений – хлоридный метод; второй – с использованием арсина (AsH3) и
хлористого водорода (HCℓ) – хлоридно-гидридный метод; третий – с использованием металлоорганических соединений (МОС). Последний метод по сути Как уже отмечалось выше, полупроводниковые твердые растворы в системе GaAs - AℓAs весьма перспективны для наноэлектроники. Однако, выяснилось, что с помощью хлоридного и хлоридно-гидридного методов нельзя выращивать соединения, содержащие Aℓ, так как AsCℓ3 реагирует со стенками кварцевого реактора. Эти соединения выращивают с помощью газофазной эпитаксии с использованием металлоорганических соединений.
Данная технология, благодаря простоте, легкости управления и другим преимуществам, потеснила хлоридную ГФЭ. В настоящее время метод ГФЭ МОС успешно применяется для выращивания гетероструктур GaAs - AℓxGa1-xAs. На примере этой системы рассмотрим аппаратурно-методическое оформление ГФЭ МОС.
В стандартном процессе ГФЭ МОС в качестве источника Ga используются металлоорганические соединения триметилгалий Ga(CH3)3 или триэтилгаллий Ga(C2H5)3, а источником As служит арсин (AsH3). Если при обычной ГФЭ выращивание проводится в горячем реакторе, то в случае
ГФЭ МОС достаточно нагревать только подложку. Степень пересыщения газовой фазы очень велика, поэтому кристаллизация осуществляется при сравнительно низких температурах (600-700) 0С, а это позволяет лучше контролировать толщину выращенных слоев.
Химическая реакция получения арсенида галлия, например, из триметилгаллия и арсина может быть записана в следующем виде:
Ga(CH3)3 + AsH3 → GaAs + 3CH4
Эта реакция протекает при 7000 С в атмосфере водорода. Подобные реакции используются для выращивания других двойных, тройных и четверных соединений. Например, рост соединений AℓxGa1-xAs описывается уравнением:
(1-x)[(CH3)3Ga] + x(CH3)3Aℓ + AsH3 → AℓxGa1-xAs + 3CH4
В этом случае атомная концентрация х алюминия задается начальными парциальными давлениями триметилгаллия и триметилалюминия в газовой фазе.
Упрощенная схема установки для ГФЭ МОС приведена на рис.3.2.

Процедура выращивания включает приготовление подложки (очистка и травление), продувку системы водородом, разогрев подложки с помощью СВЧ-индуктора, непосредственно процесс осаждения и последующий отжиг в режиме охлаждения. Транспорт необходимых соединений, включая те, что содержат легирующие примеси, осуществляется посредством несущего газа – водорода. Управление давлениями различных реагентов осуществляется с помощью расходомеров газа. Подложка располагается в графитовом держателе, который в процессе осаждения вращается для улучшения однородности наращиваемого слоя. Обычно скорость роста равна ~0,1 мкм/мин.
Как уже упоминалось, для создания приборов высокочастотной электроники и оптоэлектроники все более широко используются структуры, в том числе и многослойные, содержащие субмикронные и нанометровые слои монокристаллического кремния, а также арсенида галлия и других соединений А3В5. Во многих случаях очень важно, чтобы толщины слоев были строго определенными, границы подложка-слой или слой-слой были резкими, а толщина переходного слоя, в котором происходит изменение состава или концентрации легирующей примеси не превышала 10 нм.
Однако, обычная ГФЭ МОС не может обеспечить резких гетерограниц. В этой связи был разработан метод ГФЭ МОС с пониженным давлением газа в реакторе. Снижение давления газовой смеси позволяет эффективно управлять как градиентом концентрации примесей, так и градиентом изменения химического состава основных компонентов.
Технология ГФЭ МОС с низким давлением газа в реакторе первоначально разрабатывалась для выращивания кремния и GaAs. Затем этот метод стал применяться для выращивания InP, AℓxGa1-xAsP, GaInAsP и др. При этом значительно уменьшается влияние автолегирования, так как температура процесса не превышает (500-800)0 С в зависимости от системы.
Методом ГФЭ МОС с пониженным давлением в реакторе были созданы:
- гетероструктуры GaAs/GaAℓAs и полевые транзисторы на их основе с
селективным легированием и высокой подвижностью электронов в
двумерном электронном газе;
- инжекционные лазеры на основе гетероструктур GaAs/GaAℓAs с
квантовыми ямами;
- инжекционные лазеры, работающие на длине волны 1,3 мкм с очень
низким пороговым током;
- структуры GaInAs/InP c набором квантовых ям и др.
К недостаткам метода ГФЭ МОС относится загрязнение растущего слоя углеродом, источником которого являются металлоорганические соединения. Тем не менее, качество получаемых слоёв сравнимо с качеством, достаточным при использовании других видов эпитаксиальной технологи (например, ЖФЭ).
Основным преимуществом ГФЭ МОС является относительная простота и возможность получения эпитаксиальных гетероструктур на основе твёрдых растворов А 3В5 с управляемой толщиной и составом, и резкими границами. Метод ГФЭ МОС более производителен и перспективен для массового производства.
3.1.2. Молекулярно-лучевая эпитаксия
Молекулярно- лучевая (пучковая) эпитаксия (МЛЭ) основана на процессе взаимодействия нескольких молекулярных пучков различного состава с нагретой монокристаллической подложкой и последующего выращивания на ней эпитаксиального слоя. Формирование эпитаксиальных слоёв происходит в процессе управляемого испарения вещества из одного или нескольких источников, создающих молекулярные пучки, в условиях сверхвысокого вакуума. Рост эпитаксиальных слоёв происходит на нагретой подложке при реакции между несколькими молекулярными пучками различной интенсивности и состава. При этом обеспечивается и легко воспроизводится предельно высокое качество слоёв с заданным химическим составом и предельно высокой стехиометрией, с моноатомно гладкими гетерограницами.
В установках МЛЭ имеется возможность исследовать качество плёнок и их состав «in situ» (т.е. прямо в ростовой камере во время выращивания) и на основании результатов исследования производить корректировку технологических параметров процесса.
Технология МЛЭ была создана в конце 1960-х годов Дж.Артуром и Альфредом Чо.
Установка МЛЭ состоит из двух камер: камеры роста и камеры анализа (рис.3.3.).
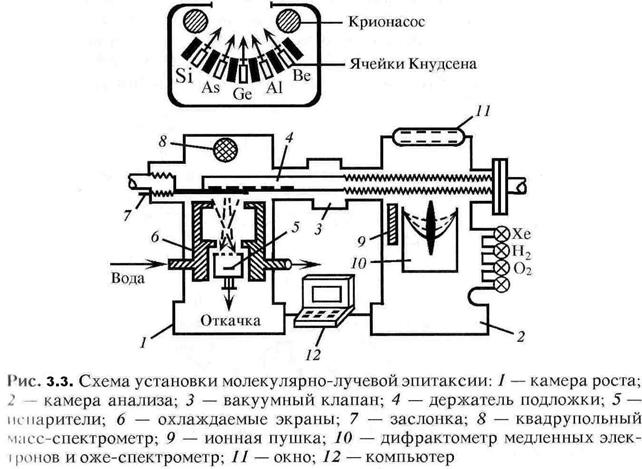
В современных установках могут использоваться три камеры, соединенные между собой:
- рабочая камера, в которой осуществляется рост структуры;
- загрузочная камера, выполняющая роль шлюза между рабочей
камерой и атмосферой;
- исследовательская камера с приборами.
В рабочих камерах создается безмасляный сверхвысокий вакуум (<10-8 Па). Для этого используется трёхступенчатая система откачки. Форвакуумный насос производит начальное откачивание газа из установки (~0,5 Па). Абсорбционный насос использует материалы с развитой поверхностью (например, порошок цеолита), которые при сильном охлаждении жидким азотом поглощают часть газа из установки. И, наконец, магниторазрядный насос обеспечивает сверхвысокий вакуум за счёт распыления титана и осаждения титановой плёнки на рабочих узлах камеры. Плёнка «прикрывает» находящийся в порах поверхности газ.
В камере роста происходит формирование эпитаксиальных плёнок. Испарительные ячейки представляют собой эффузионные ячейки Кнудсена, которые осуществляют медленное истечение испаряемых молекул через малое отверстие (рис.3.3). Основным достоинством эффузионных ячеек Кнудсена является постоянство скорости истечения из неё пара испаряемого вещества во время процесса напыления. Интенсивность молекулярного пучка у подложки может резко возрастать или падать благодаря использованию индивидуальных заслонок, помещённых между каждой из испарительных ячеек и подложкой, которые позволяют очень быстро перекрывать пучки. Это дает возможность изменять состав или тип легирующей примеси буквально на межатомном расстоянии. Тигель испарительной ячейки изготавливается из тугоплавкого материала (чистый нитрид бора или графит). От формы тигля зависят форма и однородность молекулярного пучка. Вокруг тигля наматывается нагревательная спираль. Температура нагрева каждой ячейки строго индивидуальна и контролируется термопарой. Температура испарения зависит от вещества и достигает 1900 К. От температуры зависит плотность потока вещества в пучке. Испарённое в тигле вещество в виде пучка попадает на подложку. Благодаря сверхвысокому вакууму молекулы вещества распространяются, практически по прямой, не испытывая соударения с чужеродными молекулами. С целью уменьшения теплового взаимодействия и предотвращения взаимозагрязнения источников испарительные ячейки разделяют экранами, охлаждаемыми жидким азотом. В каждой испарительной ячейке содержится один из элементов, входящих в состав растущего слоя. Количество ячеек обычно не превышает 6-ти. Температура каждой испарительной ячейки выбирается так, чтобы обеспечить выход из нее молекулярного пучка низкой интенсивности. В случае использования тугоплавких материалов или веществ с высокой химической активностью используется автотигельный метод испарения. Электронный пучок попадает в вещество и расплавляет небольшой объем, из которого происходит испарение. Таким образом вещество само является тиглем.
Держатель подложки используется для крепления подложки, ее вращения и нагрева. Встроенный в держатель нагреватель обеспечивает предварительный прогрев образца, а затем поддерживает постоянную температуру подложки. Для устранения эффектов неоднородности структур из-за несимметричности молекулярных пучков держатели подложек делаются вращающимися. Однако в этом случае все равно сохраняется радиальная неоднородность.
Технологический процесс начинается с подготовки подложки. После механической обработки (шлифовка, полировка) происходит химическое травление поверхности подложки раствором брома с метанолом, а также смесями серной кислоты, перекиси водорода и воды в различной пропорции (обычно 7:1:1). Для удаления оксида и следов углерода подложку разогревают до ~5500 С в потоке мышьяка. Смену подложек производят без разгерметизации камеры роста, используя для этой цели вакуумные шлюзы, так как достижение сверхвысокого вакуума очень длительный процесс.
После достижения сверхвысокого вакуума, охлаждения рабочих узлов жидким азотом, эффузионные ячейки выводятся на требуемую температуру. При этом заслонки остаются закрытыми. Затем начинается нагрев подложки с целью десорбции оксида на ее поверхности. В случае GaAs подложку прогревают до 580-6000 С, а в случае InP температура составляет ~5200 С. Как уже неоднократно подчеркивалось, для изготовления тонких эпитаксиальных структур с резкими границами надо проводить процесс при температурах подложки настолько низких, чтобы в процессе роста практически не происходило объемной диффузии. Оптимальная температура при осуществлении МЛЭ обычно на 100-2000 С ниже температуры, используемой при проведении эпитаксии из жидкой или газовой фазы в аналогичных системах. Например, для GaAs она составляет 500-6500 С. При такой температуре скорость роста слоя ~0,1 нм/с, что эквивалентно выращиванию одного моноатомного слоя в секунду. При выращивании слоёв GaAs методом МЛЭ атомы галлия и молекулы As2 и As4 попадают на горячую подложку GaAs. К поверхности подложки «прилипают» практически все атомы галлия. Поток атомов мышьяка делается избыточным, но только один атом As на каждый атом Ga остаётся на подложке, формируя стехиометрический состав выращиваемого слоя. Атомы As¸ не образовавшие связи с Ga, испаряются с поверхности. Интенсивность молекулярных пучков и, следовательно, скорость осаждения можно варьировать, изменяя температуру галлиевого источника. Обычно плотность потока галлия близка к 1015 атом/(см2·с), а для мышьяка она в 5-10 раз выше.
Источником молекул мышьяка является, как правило, твердый чистый мышьяк, а источником атомов галлия – твердый чистый галлий.
Для выращивания гетероструктур AℓxGa1-xAs требуется дополнительная ячейка с Aℓ. При этом соотношение Aℓ и Ga (х) в растущем слое будет пропорционально соотношению плотностей потока в их пучках.
Поскольку процесс МЛЭ происходит в сверхвысоком вакууме, его можно контролировать с помощью различных диагностических методов, поместив в установку соответствующую аппаратуру. В частности, масс-спектрометр для анализа как атомных, так и молекулярных пучков и фоновой атмосферы; дифрактометр на быстрых электронах; электронный оже-спектрометр с целью контроля состава слоя, резкости границ и взаимной диффузии; ионный вакуумметр, контролирующий нейтральные атомные пучки; квадрупольный масс-анализатор для контроля интенсивности пучков и ионную пушку для очистки поверхности подложки.
Отметим недостатки и основные достоинства МЛЭ.
Основные недостатки технологии МЛЭ.
Несмотря на достаточно простую идею, реализация технологии МЛЭ требует решения многих технических задач. К их числу относятся:
- в рабочей камере необходимо поддерживать сверхвысокий вакуум;
- чистота испаряемых материалов должна быть не ниже 99,999999% (чем
чище материал, тем он дороже;
- для осуществления контролируемого роста необходимо сложное
технологическое оборудование и исследовательские приборы;
- для обслуживания установки МЛЭ требуется специально подготовленный
персонал;
- стоимость оборудования очень высока.
Основные достоинства технологии МЛЭ:
- возможность формирования атомарно-гладких границ слоёв;
- получение счетного количества завершенных слоёв, начиная с одного
монослоя, что важно для структур с квантовыми ямами;
- возможность получения резких скачков концентрации компонентов в слоях;
- возможность создания структур со сложным распределением концентрации
основных и примесных элементов;
- наличие сверхвысокого вакуума в рабочей камере, что исключает
недопустимо высокий уровень загрязнения подложки и растущих слоёв;
- низкие температуры роста, что снижает автолегирование и диффузию в
твердой фазе;
- возможность контроля и коррекции роста непосредственно в ходе процесса.
Благодаря своим возможностям, МЛЭ в настоящее время играет главную роль в развитии нанотехнологий.
3.1.3. Значение технологии МЛЭ для современной электроники
Метод МЛЭ используется главным образом для получения высококачественных тонких плёнок и гетероструктур с нанометровыми слоями на основе полупроводниковых соединений А3В5, А2В6, SiGe и ряда других полупроводников. Современная оптоэлектроника, СВЧ -техника, светотехника, электронная техника для систем телекоммуникаций и связи работает, в основном, на полупроводниковых гетероструктурах и наногетероструктурах. Ниже приводятся многочисленные примеры применения технологии МЛЭ для получения приборных структур.
В оптоэлектронике – это солнечные элементы, ИК -фотоприемники на сверхрешётках и многослойных структурах на квантовых ямах, светодиоды и фотодиоды на сверхрешётках, лазеры на сверхрешётках, квантовых ямах и квантовых точках. Лазеры на подложках InP, излучающие на длинах волн вблизи 1,3 и 1,5 мкм (диапазон максимальной прозрачности оптоволокна) обеспечивают 70% коммуникаций Интернета. Лазеры на основе GaAs, излучающие на длине волны 0,85-0,95 мкм, работают на коротких волоконно-оптических линиях связи (ВОЛС) и используются для оптической записи. Быстро растёт рынок лазеров на основе GaAs c вертикальным резонатором на квантовых ямах и точках со специальными многослойными интерференционными отражающими зеркалами (слоями). Такие лазеры имеют малые габариты (до микронных размеров), низкий пороговый ток и хорошую диаграмму направленности, что обеспечивает более эффективный ввод излучения в волокно. Количество отражающих слоёв в лазерных структурах может составлять сотни и даже превышать 1000, при этом требуется высокая точность задания толщины этих слоёв (~1%). С помощью МЛЭ освоено производство ярких светодиодов видимого диапазона на основе гетероструктур нитрида, фосфида и арсенида галлия для экранов, табло, сигнальных устройств, бытовой и автомобильной светотехники, мобильных телефонов, фото и видеокамер. Преимуществом светодиодов по сравнению с лампами накаливания является уменьшение энергопотребления в 5-7 раз, высокая длительность работы (до десятков тысяч часов), управление световым потоком и цветом.
Приведённые примеры далеко не исчерпывают всех применений МЛЭ. Выше отмечалось, что наногетероструктуры обеспечивают наивысшие скорости пролёта электронов в приборных элементах, минимальные потери энергии и возможность управления шириной запрещённой зоны. На основе резонасно-тунельных диодов разрабатывается элементная база сверхбыстродействующих вычислительных систем.
Именно технология МЛЭ позволяет получать наноструктуры. В настоящее время МЛЭ используется для получения упорядоченных массивов квантовых точек в системах на основе А3В5 и SiGe.
В России имеются два научно-исследовательских центра, где на основе МЛЭ разрабатываются передовые технологии изготовления наноструктур. К их числу, прежде всего, относится лаборатория А3В5 в Физико-техническом институте им.А.Ф.Иоффе РАН (г.Санкт-Петербург), которой многие годы руководил Ж.И.Алферов. В этой лаборатории продолжаются разработки лазерных структур на массивах квантовых точек с использованием соединений А3В5. Ведутся также разработки УФ -лазеров на квантовых точках на основе широкозонного материала GaN. В другой лаборатории Института физики полупроводников Сибирского отделения РАН (г.Новосибирск) методом МЛЭ выращиваются сверхрешётки на основе соединений Cd HgTe для фотоприёмников в среднем (3-5 мкм), дальнем (8-14 мкм) и сверхдальнем ИК -диапазоне. В этом же институте получают СВЧ -полевые транзисторы на основе гетероэпитаксиальных структур AℓGaN – GaN. Следует заметить, что системы CdHgTe и AℓGaN очень сложны в технологическом отношении и, кроме как, методом МЛЭ, другими методами не получаются.
Для телекоммуникаций особенно важны фотоприемники и излучатели, работающие в диапазоне «окон прозрачности» атмосферы – 3-5 мкм и 8-12 мкм. В США получены ИК-лазеры на сверхрешётках, которые могут работать в диапазоне 3-12 мкм. Это каскадные лазеры, работающие на внутризонных и на межзонных переходах.
3.2. Нанотехнологии на основе самоорганизации и самосборки
3.2.1. Физико-химические основы процесса самоорганизации
Самосборка – это термин для описания процессов, в результате которых неорганизованные системы благодаря специфическому, местному взаимодействию компонентов систем приходят к упорядоченному состоянию.
Самосборка бывает как статической, так и динамической. В случае статической самосборки организующаяся система приближается к состоянию равновесия, уменьшая свою свободную энергию. В случае же динамической самосборки более корректным является использование термина «самоорганизация» (см.ниже).
Саморегулирование является одной из наиболее общих закономерностей в природе. Оно осуществляется как в органических (живых), так и в неорганических системах и осуществляется различными путями, но всегда конечному состоянию соответствует максимальная устойчивость системы. Примером саморегуляции в живой природе является образование белковых молекул, которые найдены практически во всех клетках и тканях тела и играют для жизни ключевую роль. Белки образуются последовательным соединением сотен аминокислот, каждая из которых подводится к месту своего присоединения молекулой транспортной рибонуклеиновой кислоты (РНК) в порядке, предписанном другой, несущей информацию, молекулой РНК. По прибытии на место каждая аминокислота легко связывается с предыдущей. Таким образом, последовательности аминокислот собираются в полипептидную цепь, которая непрерывно увеличивается в длине, в конце этого процесса становится устойчивой молекулой белка.
Таким образом, саморегулирование – есть проявление технологического принципа «снизу – вверх», широко распространённого в природе.
В нанотехнологии практическое применение нашли самосборка и самоорганизация. В начале рассмотрим физико-химические основы самосборки.
Самосборка – это процесс адсорбции и формирования специфического расположения молекул на твёрдой поверхности. Её движущей силой является хемосорбция, которая проявляется в высокоэнергетических реакциях между адсорбатом и адсорбирующей поверхностью. В процессе хемосорбции уменьшается поверхностная энергия системы. В отличие от сильного взаимодействия между адсорбируемой молекулой и поверхностью, взаимодействие между самими молекулами остается слабым.
Плёнки мономолекулярной толщины, сформировавшиеся по механизму самосборки, имеют очень низкую плотность дефектов, достаточно стабильны и отличаются механической прочностью.
В качестве примера самосборки рассмотрим процесс получения тонких плёнок никеля на кремниевых подложках. Их используют в качестве трафарета для литографических процессов. При этом нанометровое разрешение достигается при использовании зондов СТМ и АСМ.
Молекулярный блок для самосборки должен содержать три основные функциональные группы: группу молекул, прикрепляющую блок к поверхности за счёт хемосорбции; промежуточную группу молекул и поверхностную функциональную группу.
В качестве групп, прикрепляющих весь молекулярный блок к поверхности подложки, чаще всего используют силаны RSiX3 (R= CH3, CH5, …). Это нужно для образования связей с гидроксильными (ОН) группами, которые обычно покрывают поверхность кремния и другие технологически важные поверхности. В качестве Х компонента, замещающего в силане водород, - используются метокси-группы, хлор или их комбинация. Состав прикрепляющей группы существенно влияет на упорядоченное расположение адсорбированных молекул и на плотность их упаковки. Промежуточная группа молекул определяет взаимодействие всего хемосорбированного молекулярного блока с обрабатыващим зондом. Отдаление поверхностной функциональной группы от подложки при увеличении размеров промежуточной группы позволяет располагать зонд ближе к плёнке и тем самым понижать дозу экспонирования и пороговое напряжение. Фенильные группы, обладая определенной проводимостью, хорошо подходят в качестве промежуточных групп при электронном экспонировании зондом СТМ. Поверхностные функциональные группы (NH2) могут быть использованы для прикрепления к ним определённых молекул. Галогены (хлор, йод и др.) имеют большие сечения электронного захвата, что облегчает десорбцию галогенсодержащих фрагментов. Их последующая обработка может осуществляться с целью замены галогенных групп более активными. Поверхности, покрытые алкильными группами, инертны и гидрофобны. По своей химической активности они идентичны парафину, вследствие чего хорошо подходят для масок, использующихся при жидкостном химическом травлении.
Схематически процесс самосборки и зондовая обработка поверхности с целью получения нанометровых элементов на кремниевой подложке, показан на рис. 3.4.

Перед нанесением пленки подложку очищают и пассивируют водородом в растворе HF. Затем её окунают в раствор органосиланового мономера и высушивают, чтобы сформировать на её поверхности мономолекулярную плёнку из молекул, один конец которых закреплён на подложке, а другой образует новую поверхность (рис.3.4 а). Приготовленную таким образом мономолекулярную плёнку, типичная толщина которой составляет ~1 нм, обрабатывают по требуемому рисунку низкоэнергетическими электронами, инжектируемыми с зонда сканирующего туннельного или атомного силового микроскопа (рис.3.4 б).
После этого образец окунают в раствор с коллоидными частицами палладия, которые прикрепляются к необлучённым областям плёнки (рис.3.в). Затем образец снова высушивают и помещают в ванну для электролитического осаждения никеля. Островки палладия на поверхности служат каталитическими центрами для осаждения никеля (рис.3. г). За счёт бокового роста никелевых островков на палладии промежутки между палладиевыми островками заполняются, и образующаяся толстая плёнка никеля имеет сплошную бездефектную структуру. Приготовленную таким образом профилированную металлическую плёнку используют в качестве маски при последующем травлении. На практике разрешение при этом составляет 15-20 нм, что и является характерным размером в технологии современных ИМС.
Другим проявлением технологического принципа «снизу-вверх» является самоорганизация.
Самоорганизация – это процесс, приводящий к определённому упорядоченному расположению взаимодействующих атомов в твёрдом теле, соответствующему минимуму потенциальной энергии данной системы.
Спонтанная самоорганизация в объёме и на поверхности твёрдого тела является эффективным нанотехнолгическим способом создания квантовых нитей и квантовых точек. Практический интерес имеет саморганизация в объёме в виде спонтанной кристаллизации. Кристаллическое состояние вещества более устойчиво, чем аморфное, поэтому любая аморфная фаза имеет тенденцию к кристаллизации.
Образование кристаллических зародышей приводит к уменьшению энергии системы на величину ∆g = gam – gcr, где gcr и gam – энергии кристаллической и аморфной фаз, соответственно, в расчете на единицу объема. Этому понижению объемной энергии противостоит увеличение поверхностной энергии растущих зародышей. Образование зародышей с радиусом r и удельной поверхностной энергией σ* приводит к общему изменению свободной энергии системы на величину:
∆G = 4  r2σ* -
r2σ* - 
 r3·∆g,
r3·∆g,
которая немонотонно (кривая с максимумом) зависит от размера (радиуса) зародышей, как это показано на рис.3.5.

Изменение свободной энергии имеет максимум для кластера с критическим радиусом rkr =  . Зарождение кристаллических кластеров с радиусом меньше и больше критического требует меньшего изменения свободной энергии, чем для кластера критического размера, и система в таких условиях оказывается нестабильной. Образующиеся вследствие тепловых и структурных флуктуаций кластеры с отличными от критического радиусами тут же распадаются.
. Зарождение кристаллических кластеров с радиусом меньше и больше критического требует меньшего изменения свободной энергии, чем для кластера критического размера, и система в таких условиях оказывается нестабильной. Образующиеся вследствие тепловых и структурных флуктуаций кластеры с отличными от критического радиусами тут же распадаются.
Зародыши с критическим размером имеют благоприятные энергетические условия для последующего роста. Скорость образования кристаллитов νn пропорциональна концентрации зародышей с критическим размером и скорости их роста, которые, в свою очередь, являются экспонентциальными функциями температуры:
νn ~ exp(-∆Gcr/kB·T)·exp(-Ea/kB·T),
где ∆Gcr – изменение свободной энергии при образовании кристаллического зародыша; kB – постоянная Больцмана; Т – абсолютная температура. Член exp(-Ea/kB·Т) учитывает вклад диффузии атомов в образование зародышей и их последующий рост. Он зависит от энергии активации Еа. Поскольку величина ∆Gcr обратно пропорциональна Т2, то скорость образования кристаллитов зависит от температуры как exp(- 
 ). Очевидно, что зарождение каждой определенной кристаллической фазы происходит в узком температурном интервале, ниже которого ничего не происходит, а выше – процессы образования и распада зародышей протекают настолько быстро, что не оставляют возможности для разрастания даже зародышам с критическими размерами.
). Очевидно, что зарождение каждой определенной кристаллической фазы происходит в узком температурном интервале, ниже которого ничего не происходит, а выше – процессы образования и распада зародышей протекают настолько быстро, что не оставляют возможности для разрастания даже зародышам с критическими размерами.
3.2.2.Самоорганизация при эпитаксиальном росте как способ
формирования квантовых точек
Теперь рассмотрим самоорганизацию на поверхности твердого тела, т.е. самоорганизацию при эпитаксиальном росте.
Процесс самоорганизации при эпитаксиальном росте есть следствие стремления системы к уменьшению энергии. При осаждении атомов на подложку экспериментально наблюдаются три начальных механизма роста:

1. Механизм Франка – Ван дер Мерве. Осаждаемый материал хорошо
смачивает подложку, постоянные решеток практически совпадают. На
подложке происходит послойный двухмерный рост (рис.3.6 а).
2. Механизм Фольмера - Вебера. Осаждаемый материал не смачивает подложку, постоянные решеток сильно различаются. На подложке происходит локальный островковый (трехмерный) рост. Материал стягивается в наноостровки на поверхности подложки (рис.3.6 б). 3. Механизм Странского – Крастанова. Осаждаемый материал смачивает подложку, но имеется рассогласование постоянных решеток (порядка нескольких процентов). На начальном этапе идет послойный рост материала
на подложке. Этот слой из-за различия решеток механически напряженный. Возникает дополнительная поверхностная энергия. По мере увеличения толщины слоя упругая энергия растет, связи между атомами слоя начинают рваться. Некоторые атомы частично освобождаются. Происходит перераспределение и образуются трехмерные островки (рис.3.6 в). Когда образуются островки, решетка в этих местах частично распрямляется, происходит релаксация механических напряжений и уменьшение энергии, что соответствует равновесному состоянию.
В связи с практической важностью рассмотрим более подробно механизм самоорганизации при эпитаксиальном росте островков InAs на подложке GaAs (рис. 3.7).

Постоянная решётки InAs больше, чем у GaAs (рассогласование решеток 7%). При осаждении InAs на подложку GaAs сначала формируется тонкий слой InAs. Несмотря на различие решеток, этот слой сохраняет целостность из-за малой толщины. Образование трехмерных островков InAs начинается после осаждения 1,6 – 1,7 слоев InAs. После осаждения четырех монослоев получается плотный массив островков правильной формы (рис. 3.8).

Если на островки InAs снова нарастить GaAs, получится массив квантовых точек InAs (узкозонный полупроводник) в матрице GaAs (широкозонный). Размер и форма островков зависят от условий роста. Большинство островков имеет одинаковый размер, который соответствует минимуму энергии системы при заданных условиях роста. Островки ограняются поверхностями с малой поверхностной энергией (так называемые кристаллографические грани с низкими индексами Миллера). Например, на подложке GaAs c ориентацией (100) равновесная форма островков InAs – это правильные пирамидки с квадратным основанием. Для приборных приложений массив островков должен обладать определенными качествами: отсутствие дефектов, однородность массива по форме, взаимному расположению и размерам островков, достаточная поверхностная плотность островков. Например, для лазерных структур необходима плотность островков ~1011 см-2. Подбор оптимальных условий получения островков производится экспериментально. Существует для каждой системы минимальный и максимальный размеры островков, когда их можно рассматривать как квантовые точки. Для системы InAs – GaAs - это 4 нм и 20 нм, соответственно.
Для задания областей зарождения островков (квантовых точек) разработано несколько методов с нанометровым разрешением. Один из них основан на эпитаксиальном осаждении в окна маски, созданной путём электронно-лучевой или зондовой литографии. Другой безмасочный метод контролируемого создания массивов квантовых точек основан на использовании зонда сканирующего туннельного микроскопа (рис. 3.7). Сначала материал с острия вольфрамового зонда наносится на поверхность подложки GaAs путём подачи на зонд нескольких импульсов напряжения. Сканируя зонд вдоль поверхности подложки, наноразмерные образования создают в местах желательного расположения квантовых точек. В процессе эпитаксии GaAs сформированные ранее наноостровки остаются непокрытыми, однако постепенно они закрываются за счёт бокового роста, в результате чего образуются пирамидальные впадины. Затем производят эпитаксиальное осаждение InAs.
В заключении следует отметить, что массивы квантовых точек экспериментально получены в системах Si – Ge, InAs – InP, AℓInAs - AℓGaAs, PbSe – PbTe и в ряде других. Для формирования квантовых структур использовалась технология МЛЭ (рис. 3.7).
3.3. Метод искусственного наноформирования на основе
напряженных гетероструктур
Как уже отмечалось, переход к наноструктурам приведёт к революционным изменениям в электронике. В настоящее время достигнуты большие успехи в уменьшении размеров активных областей и создании наноструктур. Однако, создание действительно квантовых приборов, использующих квантовые явления – резонансное туннелирование, интерференцию электронных волн, квантование проводимости, кулоновскую блокаду и т.д., возможно на основе технологии, позволяющей формировать не только планарные наноструктуры, но и имеющие уникальную форму, например, в виде спиральной нанотрубки или гофрированной пленки.
Недавно сотрудники Института физики полупроводников Сибирского отделения РАН разработали метод изготовления нанооболочек сложной формы, что является первым шагом в области прецизионного конструирования трехмерных нанообъектов  . Необходимо заметить, что природа позволяет создавать подобные объекты, например, фуллерены и углеродные нанотрубки разной формы. В основе метода лежит процесс изгиба и сворачивания освобождённых от связей с подложкой напряженных полупроводниковых плёночных гетероструктур. Заметим, что напряжённые гетероструктуры образуются тогда, когда составляющие эту структуру материалы имеют большое несоответствие параметров решётки (более 1%). Например, для гетеросистемы InAs/GaAs это несоответствие достигает ~7%.
. Необходимо заметить, что природа позволяет создавать подобные объекты, например, фуллерены и углеродные нанотрубки разной формы. В основе метода лежит процесс изгиба и сворачивания освобождённых от связей с подложкой напряженных полупроводниковых плёночных гетероструктур. Заметим, что напряжённые гетероструктуры образуются тогда, когда составляющие эту структуру материалы имеют большое несоответствие параметров решётки (более 1%). Например, для гетеросистемы InAs/GaAs это несоответствие достигает ~7%.
Поэтому создание гетероструктуры на основе этих материалов с когерентными границами сопряжения возможно только тогда, когда толщина InAs на GaAs не будет превышать критическую величину. При этом несоответствие
___________________________________
*)В.Я. Принц. Самоинформирующиеся прецизионные 3D наноструктуры для будущих приборов наноэлектроники и наномеханики (НИОКР).
http://Popnano.ru/science...(03.10.2008)
параметров решёток будет аккомодироваться упругой деформацией слоев InAs, а гетероструктура будет напряжённой. Предложенным методом можно создавать целый класс полупроводниковых наноструктур: трубки, спирали, кольца, гофрированные плёнки и т.д.
В качестве примеров, рассмотрим применение метода искусственного наноформообразования на основе напряжённых полупроводниковых гетероструктур для изготовления нанотрубок и периодически гофрированных плёнок.
3.3.1. Метод изготовления нанотрубок самосворачиванием
полупроводниковых гетероструктур
Для того, чтобы изготовить нанотрубку, необходимо первоначально иметь планарную гетероструктуру с напряжёнными слоями с минимальной толщиной в два монослоя. Подходящей для этого является МЛЭ.
На рис.3.9 схематически показан процесс формирования нанотрубок на примере гетероструктуры GaAs/InAs.

Постоянные решёток слоёв GaAs и InAs, как уже отмечалось, значительно различаются (~7%). В начале на подложке InP выращивают слой AℓAs (жертвенный слой), затем слой InAs и сверху слой GaAs (3. 9, а). В результате образуется напряженная гетероструктура, в которой решётки материалов подстраиваются под решётку подложки, и слой InAs оказывается сжат, а слой GaAs - растянут (рис.3. 9, б). При освобождении плёнки GaAs/InAs от связи с подложкой межатомные силы будут стремиться увеличить расстояния между атомами в сжатом слое InAs и уменьшить их в растянутом слое GaAs. Возникающие в слоях InAs и GaAs силы межатомного взаимодействия F1 и F2 противоположно направлены и создают момент сил М, изгибающий плёнку GaAs/InAs (рис. 3. 9, в). В результате этого изначально плоская гетероплёнка сворачивается в трубку (рис.3.9, г). Для освобождения плёнки GaAs/InAs от связи с подложкой используется селективное травление жертвенного слоя AℓAs. Диаметр D свёрнутых гетероструктур определяется толщиной сворачиваемой гетероплёнки d и величиной упругих напряжений в ней. В простейшем случае гетероплёнки, состоящей из двух слоёв равной толщины, D  d/(∆а/a), где ∆а/a – рассогласование параметров решёток этих слоёв.
d/(∆а/a), где ∆а/a – рассогласование параметров решёток этих слоёв.
Экспериментально из плёнок GaAs/InAs получены трубки с внутренним диаметром до 2 нм. Высокое качество выращенных методом МЛЭ гетероструктур позволяет получать свёрнутые гетероструктуры длиной до нескольких сантиметров с гладкими, однородными по толщине стенками. Расположение, длина и ориентация трубок на подложке задавались изготовлением с помощью литографии исходных меза-структур различной геометрии (прямоугольников, полосок и т.д.). Область вокруг мезы протравливалась до подложки для обеспечения доступа селективного травителя к жертвенному слою AℓAs. В результате селективного травления слоя AℓAs напряженная гетероплёнка освобождалась от связи с подложкой и сворачивалась в трубку-свиток. Количество витков определялось временем травления AℓAs и могло достигать 40. Трубка оставалась закреплённой на подложке в месте, где слой AℓAs не был удалён.
Описываемый метод формирования микро- и нанотрубок может быть применён к полупроводниковым приборам, металлическим и диэлектрическим плёнкам, технология выращивания которых методом МЛЭ хорошо отработана. Имеются данные об изготовлении SiGe/Si – трубок с диаметром от 10 мкм до 10 нм.
Достоинством технологии самоформирующихся наноструктур является возможность достижения высокой точности задания внутреннего диаметра трубки, её длины и количества витков до начала свёртывания плёнки.
На рис. 3.10 схематично показан процесс, позволяющий создавать периодическую в радиальном направлении структуру с расстоянием между витками, прецизионно задаваемым длиной молекул, формирующих плёнку Ленгмюра-Блоджетт (Л-Б).

Плёнки Л-Б наносились на поверхность исходной структуры стандартным методом. Экспериментально были сформированы гибридные микро-и нанотрубки на основе бислоёв InGaAs/GaAs и плёнок Л-Б, содержащих 2,4,6 и 20 монослоёв, каждый толщиной ~3 нм. Внутренний диаметр трубки изменялся в диапазоне от 80 нм до 8 мкм.
3.3.2. Метод изготовления периодически гофрированных тонких
плёнок, содержащих квантовые точки
Как отмечалось ранее, достижение прецизионных размеров в квантовых приборах необходимо как для организации массового производства, так и для правильного функционирования приборов, поскольку процессы туннелирования, размерное квантование и другие процессы строго связаны с размерами.
Рассмотрим новый подход к созданию туннельно связанных периодических наноструктур.
Метод основан на использовании выращенных с помощью молекулярной эпитаксии напряжённых плёнок и на процессах самоформирования, происходящих при отсоединении от подложки сжатых плёнок.
Упрощённую последовательность формирования выпуклой плёнки InAs, освобождённой от связи с подложкой InP в локальной области L, схематично иллюстрирует рис. 3.11.

Исходная сжатая плёнка при её освобождении от подложки упруго релаксирует, увеличивая свою длину, и выпучивается с амплитудой А, которая зависит от длины L и несоответствия постоянных решёток ∆а/а по формуле:
А = 1,3L·(∆а/a) ½
При ∆а/а = 5% амплитуда выпуклой области, на основании теории упругости, составляет треть от длины.
Описанным методом получены периодически гофрированные наноструктуры на основе сверхтонких напряжённых полупроводниковых слоёв InAs, InGaAs/GaAs, SiGe/Si. Для достижения прецизионности вводились ограничения на амплитуду гофрировок. Для этого на этапе молекулярной эпитаксии в структуру дополнительно вводились расположенные выше и ниже на заданном расстоянии от напряжённого слоя ненапряжённые слои, которые и ограничивали амплитуду (рис. 3.12).

Поскольку МЛЭ позволяет задавать толщину эпитаксиальных слоёв, а, следовательно, и расстояние между слоями с атомной точностью, то получаемые вышеописанным способом гофрировки будут иметь прецизионные амплитуду и период.
Почему в гофрированной плёнке возникают квантовые точки? При изгибе внешние слои плёнки растягиваются, а внутренние – сжимаются, что существенно изменяет ширину запрещённой зоны в данной области. В тонких плёнках деформация может достигать 10%. Такая гигантская деформация существенно изменяет ширину запрещённой зоны в месте изгиба, создавая квантовую яму. Оценка ∆Е в тонких плёнках дает величину ~1 эВ, т.е. имеющиеся в гофрированных структурах упругие деформации вызывают сдвиги краев зон и приводят к появлению системы потенциальных ям.
Как показали расчёты, при периодах гофрировки меньше 100 нм электронные состояния локализованы в отдельных ямах. При уменьшении периода наноструктура может рассматриваться как система туннельно связанных квантовых точек. Положение дискретных энергетических уровней в квантовых точках можно задавать путём изменения толщины и периода гофрировки.
Основные достоинства технологии самоформирующихся прецизионных 3 D наноструктур сводятся к следующему:
• диаметр D свёрнутых гетероструктур задаётся в процессе МЛЭ исходной структуры с высокой точностью от сотен микрометров до нескольких нанометров; высокое качество гетероструктур, выращенных методом МЛЭ, позволяет получать свёрнутые наноструктуры длиной до нескольких сантиметров с гладкими, однофазными по толщине стенками;
• самоформирующиеся наноструктуры могут быть изготовлены из широкого
набора материалов, включая InGaAs/GaAs, SiGe/Si, плёнки Л-Б, а также
металлы и диэлектрики;
• метод позволят получать разнообразные оболочки и формы в виде трубок,
колец, спиралей, гофр, волокон, игл и т.д., а также собирать на их основе
сложные функциональные конструкции;
• метод хорошо стыкуется с технологией изготовления интегральных схем и
полупроводниковых приборов.
3.4. Нанолитография как основной метод создания
поверхностных наноструктурных объектов
3.4.1. Литография и её виды
Литографией в микроэлектронике называют различные методы микрогравировки диэлектрических, металлических и полупроводниковых слоев, используемых при изготовлении ИМС. Существуют виды литографии, основанные на использовании электромагнитного излучения, потоков электронов и ионов, силового воздействия зондом на поверхность в наномасштабе. В этой связи разработаны оптическая, рентгеновская, электронно-лучевая, ионная литографии. Разрабатываются и другие варианты литографии специально для нанотехнологий – импринт-литография и зондовая нанолитография.
Основным вариантом литографии в настоящее время остаётся оптическая, в которой используется видимое и примыкающее к нему ультрафиолетовое излучение. Этот вариант литографии называется фотолитографией. Фотолитография представляет собой метод фотохимической микрогравировки слоёв. Фотолитография может быть контактной и проекционной. В контактной литографии на слой фоторезиста накладывается фотошаблон. В проекционной фотолитографии фотошаблон не контактирует с фоторезистом, а отделён от него специальной оптической проекционной системой. Эта система фокусирует изображение рисунка фотошаблона в плоскости расположения слоя фоторезиста (обычно с уменьшением масштаба). В настоящее время в серийном производстве микросхем используется преимущественно проекционная литография.
Суть литографии можно уяснить на примере контактной фотолитографии на поверхности кремниевой подложки (рис. 3.13).

Основные этапы контактной фотолитографии включают:
- нанесение на пластину кремния диэлектрика, обычно диоксида кремния
SiO 2 (рис. 3.13, а);
- нанесение на слой диэлектрика фоточувствительного слоя – фоторезиста
(рис. 3.13, б);
- наложение на слой фоторезиста фотошаблона, который отображает
соответствующую часть топологии ИМС.
Фотошаблон представляет собой непрозрачную пластину с прозрачными участками, дублирующими форму и местоположение будущих активных элементов микросхемы (рис. 3.13, в);
- экспонирование фоторезиста (в простейшем варианте видимым или
ультрафиолетовым светом); экспонирование изменяет скорость
последующего растворения фоторезиста в специальном травителе
(рис. 3.13, в);
- удаление фотошаблона;
- травление фоторезиста; участки, подвергнутые излучению, вытравливаются
до слоя окисла (рис. 3.13, г);
- вытравливание отверстий («окон») в слое диэлектрика через отверстия в
фоторезисте (1 и 2 на рис. 3.13, д);
- удаление фоторезиста (рис. 3.13, е).
Наименьший размер элемента ИМС определяется возможностями литографии. В этой связи возникает вопрос о разрешающей способности литографии, которая ограничена как техническими, так и физическими факторами.
3.4.2. Разрешающая способность фотолитографии
Разрешающей способностью метода фотолитографии называется число линий N одинаковой ширины аmin, разделённых промежутками той же ширины, которое можно получить на 1 мм поверхности резиста: N =  , где аmin выражено в мкм. На практике разрешающую способность характеризуют также значением а min. В дальнейшем под разрешающей способностью будет подразумеваться величина а min. Эта величина определяет минимальные топологические размеры элементов ИМС.
, где аmin выражено в мкм. На практике разрешающую способность характеризуют также значением а min. В дальнейшем под разрешающей способностью будет подразумеваться величина а min. Эта величина определяет минимальные топологические размеры элементов ИМС.
Физический предел разрешающей способности фотолитографии определяется для проекционной системы дифракционным критерием Рэлея, при выполнении которого изображения двух близко расположенных точек видны раздельно:  , где k – коэффициент пропорциональности;
, где k – коэффициент пропорциональности;  - длина волны излучения;
- длина волны излучения;
n – показатель преломления среды; Θ– половина апертурного угла выхода. Величина nSin Θ называется числовой апертурой. Значения k различны для разных λ и резистов (например, k  0,3 - 0,6 для УФ-излучения). Из приведённой формулы видно, что
0,3 - 0,6 для УФ-излучения). Из приведённой формулы видно, что  min уменьшается при использовании более коротковолнового излучения и объектива с большой числовой апертурой. Кроме того, на величину аmin влияет ещё ряд факторов: качество резистов и шаблонов, плоскостность пластин и др. Чем короче λ, тем более мелкие детали могут быть перенесены на пластину. Согласно эмпирическому правилу, при длине волны λ можно отобразить детали размером до λ/2.
min уменьшается при использовании более коротковолнового излучения и объектива с большой числовой апертурой. Кроме того, на величину аmin влияет ещё ряд факторов: качество резистов и шаблонов, плоскостность пластин и др. Чем короче λ, тем более мелкие детали могут быть перенесены на пластину. Согласно эмпирическому правилу, при длине волны λ можно отобразить детали размером до λ/2.
3.4.3. Основные достижения традиционных методов
фотолитографии
Как отмечалось выше, главным фактором, повышающим разрешающую способность фотолитографии, является уменьшение длины волны излучения. Поэтому развитие традиционных вариантов фотолитографии шло по пути использования излучения с малой длиной волны.
Первоначально в качестве источников излучения широко применялись ртутные лампы. В последние годы стандартными стали две линии в спектре ртути с длинами волн 435 и 365 нм, соответственно. При помощи источника излучения с длиной волны 365 нм вычерчиваются линии шириной 0,35 мкм, что почти соответствует длине волны.
С середины 80-х годов в фотолитографии стали использовать ультрафиолетовое излучение с длиной волны 248 нм. Это литография «глубокого ультрафиолета – ГУФ». Благодаря переходу на ГУФ, стало возможным получать разрешение в 0,25 мкм. До 2003 года в фотолитографии наиболее широко использовалась длина волны λ = 248 нм излучения КrF – эксимерного лазера, (эксимерными называются газоразрядные лазеры, активной средой в которых являются молекулы галогенов инертных газов), что позволило получить разрешение аmin  120 нм. Переход на размеры, меньшие длины волны, стал возможным благодаря различным специальным методикам, снижающим дифракцию света. Теоретически возможно формирование линий с шириной, вдвое меньшей по сравнению с длиной волны. Для достижения высокой разрешающей способности литографии также очень важны свойства резиста, подвергаемого облучению. Следующим этапом развития фотолитографии явилось использование излучения с
120 нм. Переход на размеры, меньшие длины волны, стал возможным благодаря различным специальным методикам, снижающим дифракцию света. Теоретически возможно формирование линий с шириной, вдвое меньшей по сравнению с длиной волны. Для достижения высокой разрешающей способности литографии также очень важны свойства резиста, подвергаемого облучению. Следующим этапом развития фотолитографии явилось использование излучения с
λ = 193 нм (эксимерные Ar – лазеры). Крупнейшая компания, производящая чипы, Intel сообщила в конце 2003 года о начале производства ИМС с элементами размером ~90 нм. В дальнейшем возможен переход к излучению с λ = 157 нм (эксимерные F - лазеры), аmin  70 нм. Однако кварцевые линзы уже не прозрачны для этой длины волны. Необходимы линзы из GaF2 – менее прочного, неустойчивого к внешним воздействиям и более дорогого материала. Для λ <150 нм уже нет прозрачных материалов и, при дальнейшем уменьшении λ, неизбежен переход на зеркальную оптику с полной заменой фотолитографического оборудования, что требует огромных финансовых затрат.
70 нм. Однако кварцевые линзы уже не прозрачны для этой длины волны. Необходимы линзы из GaF2 – менее прочного, неустойчивого к внешним воздействиям и более дорогого материала. Для λ <150 нм уже нет прозрачных материалов и, при дальнейшем уменьшении λ, неизбежен переход на зеркальную оптику с полной заменой фотолитографического оборудования, что требует огромных финансовых затрат.
Так как метод фотолитографии имеет высокую технико-экономическую эффективность и степень отработанности, полупроводниковая электроника стремится использовать этот метод до тех пор, пока не будут исчерпаны все его возможности. Ведущие мировые корпорации – IBM, Intel и др. вкладывают большие средства в разработку новых альтернативных вариантов фотолитографии с аmin < 90 нм. В последнее время наметились два пути: использование иммерсии и переход к экстремальному ультрафиолету (ЭУФ).
В иммерсионной литографии используется прозрачная жидкость с высоким коэффициентом преломления, которая заполняет пространство между проекционными линзами и полупроводниковой пластиной. Эффект иммерсии заключается в уменьшении длины волны λ и увеличении числовой апертуры nSin Θ (за счет n >1). Компания Intel создала технологию иммерсионной оптической литографии, получив на практике структуры с минимальным размером элементов ~30 нм.
Нанолитография в экстремально дальнем вакуумном ультрафиолете (ЭУФ) использует излучение в диапазоне 10-50 нм. Метод ЭУФ рассчитан на промышленное применение и в настоящее время успешно развивается. Презентация первой ЭУФ -установки проведена в 2001 году. Установка позволяла получать аmin ~ 80 нм. В настоящее время достигнуто разрешение ~30 нм. Ожидается, что к 2014-2016 годам промышленные ЭУФ -нанолитографы дадут разрешение ~20 нм, а в последующие годы – до 10 нм (см.рис. 3.14).


Для перехода к ещё более меньшим проектным нормам используют экспонирование резистов с помощью рентгеновского излучения.
Принципы и основные этапы рентгенографии и фотолитографии одинаковы, но в рентгенографии для экспонирования резистов используется рентгеновское излучение с длиной волны 0,5 – 5 нм. Достоинства рентгенолитографии – высокая разрешающая способность и высокая производительность, обусловленная малым временем экспонирования и возможностью получения изображения на больших площадях. Рентгенолитография используется для изготовления наноструктур, но из-за сложности и дороговизны оборудования пока не применяется в серийном производстве.
3.4.4. Электронно-лучевая литография
Метод ЭЛЛ основан на использовании электронных пучков для экспонирования резистивных плёнок. При взаимодействии такого пучка с резистом разрываются межатомные связи, что приводит к перестройке молекулярной структуры резиста и изменению его свойств, в частности, изменению растворимости.
Электронолитография обладает более высоким разрешением, чем фото- и рентгенолитография. Это обусловлено меньшей длиной волны излучения. Известно, что длина волны де Бройля для электронов, движущихся со скоростью  , равна λ=
, равна λ=  , где U – ускоряющее напряжение; m – масса электрона. Например, эквивалентная длина волны электронов при средних значениях U = 50 кВ и U = 5 В равна λ = 0,6·10-2 нм и λ = 0,6 нм, соответственно. Поэтому дифракционные ограничения при использовании ЭЛЛ не возникают. При малых λ разрешение может достигать величины, близкой к 0,1 нм. Однако на практике разрешение составляет около 50 нм. Благодаря малости λ электроны могут быть сфокусированы в пучок диаметром ~0,5 нм, что позволило получить в научных исследованиях разрешение ~1,3 нм.
, где U – ускоряющее напряжение; m – масса электрона. Например, эквивалентная длина волны электронов при средних значениях U = 50 кВ и U = 5 В равна λ = 0,6·10-2 нм и λ = 0,6 нм, соответственно. Поэтому дифракционные ограничения при использовании ЭЛЛ не возникают. При малых λ разрешение может достигать величины, близкой к 0,1 нм. Однако на практике разрешение составляет около 50 нм. Благодаря малости λ электроны могут быть сфокусированы в пучок диаметром ~0,5 нм, что позволило получить в научных исследованиях разрешение ~1,3 нм.
На практике применяют два вида ЭЛЛ – сканирующую и проекционную. Проекционные системы, как правило, имеют высокую производительность и более просты, чем сканирующие системы. Носителем информации об изображении является маска (шаблон). Изображение с шаблона передается на пластину лучом электронов. В методе сканирующей электронно-лучевой литографии сфокусированный пучок электронов, управляемый компьютером, перемещается по поверхности подложки, покрытой резистом, вычерчивая заданный рисунок. Достоинство метода – возможность наносить рисунок на резист без шаблона. При изменении чертежа достаточно просто изменить программу для ЭВМ. Недостаток – длительность формирования рисунка, что ограничивает производительность метода.
В настоящее время промышленные установки и сканирующие электронные микроскопы работают в интерв
Дата публикования: 2014-11-18; Прочитано: 9303 | Нарушение авторского права страницы | Мы поможем в написании вашей работы!
